ADI (After Develop Inspection) : 현상 후 패턴 검사
| 검사항목 | 장비 |
| CD, 패턴 | SEM (Scanning Electron Microscope) |
| Particle | 이물질 카운터 (Particle Counter) 광학 현미경 (Optical Microscope) |
| Overlay | O/L 전용 장비 |
CD (Critical Dimension): 가장 작은 크기의 회로 선폭, 간격, 홀 크기 등
HM (Hard Mask)
Resolution Improving Tech
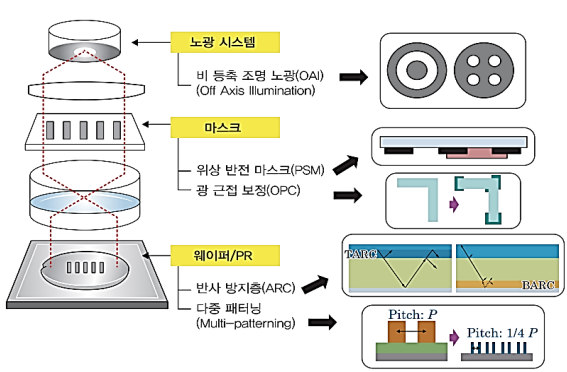
OAI (Off Axis Illumination) : 수직 입사 광원이 0차광 이상 집광하지 못해 보완하기 위해 빛 사입사시키는 것
PSM (Phase Shift Mask): 빛의 상쇄간섭을 일으켜 원하는 부분만 PR이 남아있게 보완한 마스크
OPC (Optical Proximity Correction): 포토 공정 후 패턴의 왜곡을 미리 예상하여 설계시부터 패턴의 일부를 보정하는 것
ARC (Anti-Reflective Coating): 구조물에 의해 빛이 반사되어 생기는 노칭 등의 현상을 방지하기 위해 코팅하는 반사방지층 (TARC/BARC- 각각 Top, Bottom)
Multi Patterning
SADP (Self Aligned Double Patterning): 자기정렬 방식 패터닝. 스페이서를 이용하여 피치를 1/2로 감소
SAQP (Self Aligned Qudraple Patterning): SADP를 1회 더 진행하여 피치를 1/4로 감소. 주로 규칙적인 메모리 제품에 사용
각 공정 단계 약자
AEI (After Etch Inspection)
APEI (After Partition Etch Inspection)
ASEI (After Spacer Etch Inspection)
AFEI (After Final Etch Inspection)
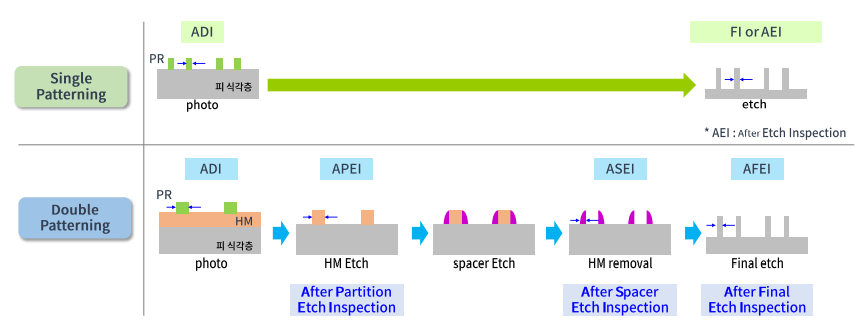
O/L
IBO (Image Based Overlay): 상, 하부 특정 패턴이 겹치는 Overlay key 사용, 회절 이용
- BIB (Box In Box)
- AIM (Advanced Imaging Metrology)

DBO (Diffraction Based Overlay): 상, 하부 특정패턴이 안겹치는 Overlay key 이용, 중심 값 차이 이용하여 오차 정렬
Equipment
APC (Advanced Process Control): 실시간을 센서를 사용하여 공정 제어. 이전 결과 data들을 받아 실시간으로 모델링
FDC (Fault Detection & Classification): 모델과 현재 장비 상태 비교 분석하여 장비의 상태를 파악하고 오류를 감지
SPC (Statistical Process Control): 통계적 공정관리

T2T (Tool to Tool): 설비-설비 간
C2C (Chamber to Chamber): 동일한 설비 내에서 챔버-챔버 간
Result
EL (Exposure Latitude): 노광 과정에서 CD변화가 허용되는 exposure dose 의 범위. EL이 작아질 수록 CD는 DOSE 에 sensitive 하다.
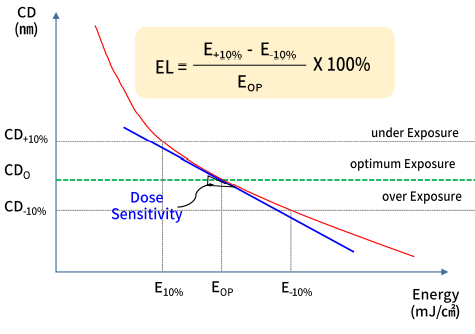
NILS (Normalized Image Log-Slope): 이미지의 기울기, 폭을 이용하여 정규화 한 값. 얼마만큼 이미지가 define이 잘 되었는가를 나타냄. 기울기가 크면 클수록 좋음
LER (Line Edge Roughness): 선단거칠기
Inspection
APMI (Actinic Pattern Mask Inspection): EUV 마스크는 e-beam등 기존의 광학으로는 5nm이하 크기 검사가 불가능 -> 더 깊이 침투해있는 파티클을 검사해야해서 EUV마스크를 EUV로 검사하는 기술
Material
LTEM (Low Thermal Expansion Material): 저 열팽창 계수 물질
CNT (Carbon NanoTube): EUV용 펠리클의 멤브레인으로 사용되기도 함
'Semiconductor > Photolithography' 카테고리의 다른 글
| [단위공정/Lithography] 공정 Parameter (0) | 2022.01.26 |
|---|---|
| [단위공정/Lithography] PR의 종류 (0) | 2022.01.26 |


댓글